New failure modes not observed in Silicon appear while testing SiC MOSFET and Schottky diodes and under heavy ions radiation. Gate damage in transistors remains undetected even monitoring drain current and gate leakage of the transistor under high voltage biasing conditions.
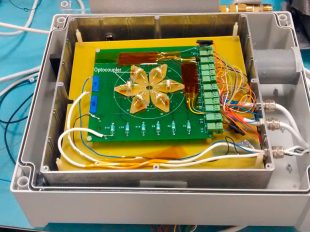
En aplicaciones espaciales, los optoacopladores pueden necesitar trabajar a temperaturas muy bajas. Bajo estas condiciones de operación a baja temperatura, la degradación del dispositivo sometida a exposición a la radiación puede mostrar un comportamiento diferente en...

La evaluación de confiabilidad de los Fotódulos Pin SI del Área fue un tema de exhibición en el Primer Simposio Internacional sobre Confiabilidad de Optoelectrónica para el Espacio que tuvo lugar en Cagliari, Italia, entre el 11 y el 14 de mayo de 2009. INTA, the Instituto...

Los efectos de evento único se vuelven cada vez más importantes debido a la evolución de la tecnología de los dispositivos, el aumento de la demanda de uso de COTS (y otros dispositivos no caracterizados contra la radiación) y los requisitos de radiación solicitados por nuevas...

Alter Technology realiza: Prueba de compatibilidad electromagnética de acuerdo con MIL-STD-461 E / F, MIL-STD-461, EN 61326-1, Prueba de seguridad de acuerdo con EN 61010-1 y Prueba ambiental de acuerdo con MIL-STD-810 F / G /G