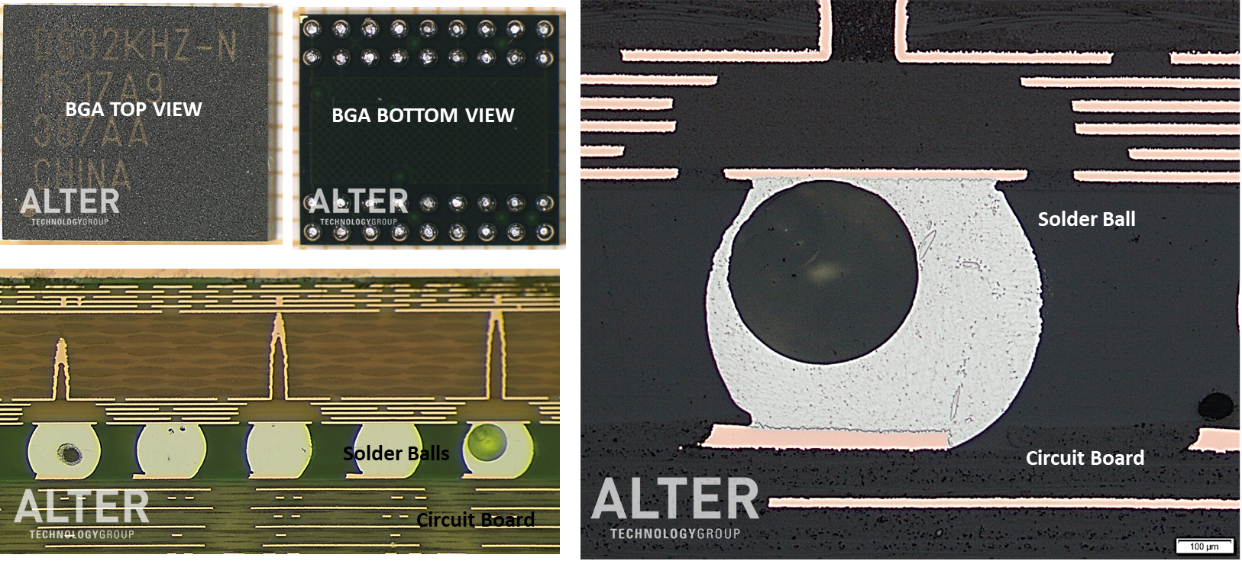 Ball Grids Array (BGA) device is metallographic prepared in ALTER TECHNOLOGY Materials & Processes Laboratory, recognized as a recommended facility for such activity by ESA authority (MEMO ESA-TECMSP-MO-013165).
Ball Grids Array (BGA) device is metallographic prepared in ALTER TECHNOLOGY Materials & Processes Laboratory, recognized as a recommended facility for such activity by ESA authority (MEMO ESA-TECMSP-MO-013165).
Sample & Method
BGA device assembled to a PCB has been submitted to the ECSS verification programme following the guideline defined in the ECSS standard ECSS-Q-ST-70-38C. Metallographic analysis allows us to check the status of such devices after performing the environmental tests (Vibration & Thermal Cycling).
Remark
An in-depth cross-section analysis allows us to evaluate the impact of voiding on the solder joint integrity of BGAs.
This microsection evaluation reveals macrovoids, also called process voids, on the solder joint. This cavity is the result of outgassing flux that has insufficient time to scape during the reflow process and it is trapped. These voids are characterized by a diameter size between 100 to 300 µm.
- MacroVoids in assembled BGA packages - 14th August 2019
- Microsection Inspection / Constructional Analysis - 23rd July 2019
- Microsection Inspection / Failure Analysis - 19th July 2019