Scanning Acoustic Microscopy (SAM) has proved to be the most effective tool for the non-destructive detection of very thin (even below 200 nm of thickness) internal anomalies (delamination, voids, cracks, and foreign material) within ceramic capacitors and other EEE parts

Micrometric-wide internal features of sub-micrometric thickness can be easily detected in our recently upgraded instrument. The high lateral resolution is within the current state of the start in the non-destructive inspection of deeply embedded objects.
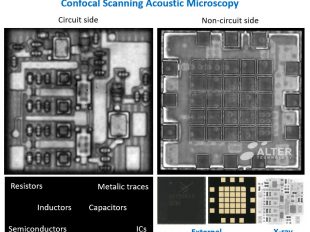
Hybrid microelectronics within plastic packages are comprehensively inspected thanks to the con-focal resolution provided by the scanning acoustic microscopy technique.
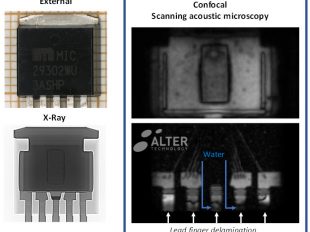
High-current low dropout regulator encapsulated in a TO-263 package is inspected by confocal scanning acoustic microscopy (C-SAM). Probe frequency and inspection procedure is adapted to the internal structure of this plastic encapsulated microelectronic part.
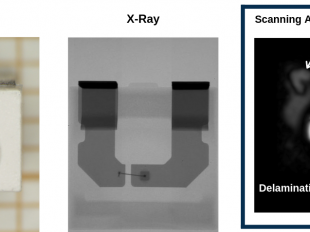
An Infra-red led emitter is inspected by scanning acoustic microscopy. Probe frequency is adapted to the characteristics of the system. In this case, considering the large thickness of the package a 50 MHz transducer is used. Our phase inversion algorithm identifies and...
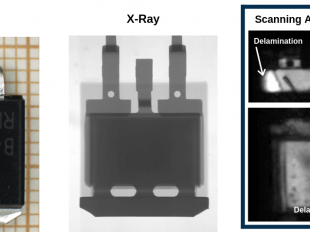
High-resolution inspection of plastic encapsulated systems with complex internal architectures requires of confocal imaging techniques to block out-of-focus features that otherwise impair the resolution and the image quality.

Non-destructive testing methods are critical for the screening, inspection and failure analysis of plastic encapsulated and other EEE systems. Typical non-destructive testing activities involving EEE parts are grouped in three main categories: • Functional inspection (electrical...

Scanning Acoustic Microscopy (SAM) is an inspection that uses focused sound to investigate, measure, or obtain an internal image of an object. It is commonly used in failure analysis and non-destructive evaluation. The semiconductor industry has found the SAM, particularly the C...