Los defectos internos (invisibles) de fabricación y de los materiales pueden comprometer críticamente el rendimiento de las piezas microelectrónicas encapsuladas. Del mismo modo, los fallos de construcción accidentales (piezas que faltan) y las falsificaciones suponen un problema nada desdeñable en el mercado actual de los AEE. Por lo tanto, las herramientas de inspección no destructiva fiables son esenciales para la adecuada identificación y detección de defectos internos en los sistemas encapsulados.
Sin embargo, la inspección no destructiva interna se convierte en una tarea difícil debido a la mayor complejidad y miniaturización de los conjuntos de AEE actuales, por ejemplo, los paquetes a escala de chip y las pilas de circuitos integrados en 3D. En este sentido, la microscopía acústica de barrido (SAM) es uno de los métodos preferidos para la inspección no destructiva de conjuntos y componentes microelectrónicos.
- CI encapsulados en plástico
- Sistemas Flip Chip (CGA, FCBGA, PBGA, FPBGA…)
- Obleas adheridas
- Placas de circuito impreso
- Condensadores
- MEMS…
Entre otros tipos de fallos, las técnicas acústicas son especialmente adecuadas para la detección de aquellas irregularidades relacionadas con los materiales y los cambios de densidad, incluidos los huecos y la porosidad, así como las grietas y la deslaminación. En particular, la microscopía acústica ha demostrado ser el método no destructivo por excelencia para la identificación de delaminaciones de aire ultrafinas en sistemas multicapa, siendo sensible a características de aire de espesor submicrométrico. Por ello, este método de ensayo no destructivo se incluye en diferentes programas de verificación de control de calidad, como el nuestro:
- IPC/JEDEC J-STD-020E “Moisture Reflow Sensitivity Classification for Nonhermetic Surface Mount Devices”
- GEIA-STD-0006 “Requirements for Using Solder Dip to Replace the Finish on Electronic Piece Parts”
- MIL-STD-883 Test Method 2030 “Ultrasonic Inspection of die attach”
- MIL-STD-1580 “Destructive Physical Analysis for Electronic Electromagnetic and Electromechanical Parts”
- MIL-PRF-123 ”Capacitors Fixed Ceramic Dielectric (Temperature Stable and General Purpose), High Reliability, General Specification For”
- MIL-PRF-31033 “Capacitor Fixed Ceramic Dielectric High Reliability Discoidal General Specification For”
- MIL-PRF-49470 Capacitors, Fixed Ceramic Dielectric Switch Mode Power Supply (General Purpose and Temperature Stable) Standard Reliability and High Reliability, General Specification For
Fallos generales:
- Interfaces no adheridas (por ejemplo, obleas adheridas)
- Inclinación de la matriz o ahuecamiento
- Desencolado de las láminas
- Fijación porosa o insuficiente de la matriz
- Grietas en la matriz
- Huecos en el compuesto de moldeo
- Grietas en el paquete de chips
- Deslaminación dentro del sustrato

Arreglos de parrilla de bolas y fallos específicos.
- Defectos en pilares de Cu, bolas de soldadura y TSVs
- Exceso de altura de relleno o de material de fijación de la matriz
- Desprendimiento de la máscara de soldadura o del “dedo de plomo”
- Grietas en el paquete BGA
Fallos específicos de los circuitos integrados
- Grietas en el paquete de CI (grietas “popcorn”)
- Deslaminación del marco de plomo

Fallos específicos de los módulos híbridos y multichip (MCM)
- Integridad de la soldadura del disipador de calor
- Calidad de la unión del sello de la tapa
- Insuficiente material de soldadura
- Exceso de reflujo de la soldadura
- Integridad de la junta
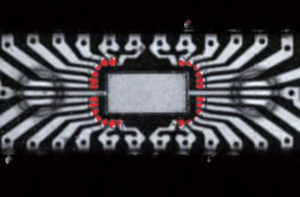
INFORMACIÓN EN TIEMPO REAL
Nuestra plataforma Vitual Lab para pruebas remotas proporciona a los usuarios de Alter Technology:

- Acceso instantáneo a los resultados de las pruebas
- Chat en vivo con nuestros inspectores durante y después de la duración de la prueba
- Acceso a la base de datos de Alter Technology (30 años de datos acumulados) para comparar el rendimiento con otros lotes y componentes similares.
Gracias a la herramienta del Laboratorio Virtual, el cliente puede idear su propia solución de ensayo adaptada específicamente a las necesidades y requisitos reales y supervisar los resultados del ensayo en tiempo real, sin necesidad de esperar a que se completen todas las actividades. Así, el usuario final puede adaptar las zonas y los planos de inspección en función de los resultados iniciales. También recibirá comentarios y consejos de nuestros ingenieros de pruebas durante o después de la inspección.
Se puede acceder a los registros de inspección detallados inmediatamente después de la finalización de la actividad. De este modo, los fabricantes y usuarios ganan un tiempo valioso para desarrollar planes de contingencia y soluciones para abordar las anomalías detectadas.
- Detección no destructiva de características internas micrométricas en sistemas microelectrónicos de EEE. - 3rd enero 2022
- Inspección acústica de sistemas híbridos en sustratos laminados - 3rd enero 2022
- Entrada de agua a través de piezas delaminadas en sistemas encapsulados de plástico - 3rd enero 2022