SEM – EDS
Esta técnica analítica puede proporcionar información cualitativa y cuantitativa sobre la composición de una superficie (por ejemplo, la identificación de los elementos y el peso de estos, respectivamente). La técnica se basa en la detección y la espectroscopia de radiación secundaria (rayos X) emitida cuando un haz de electrones incidente de alta intensidad incide en los materiales situados en su trayectoria. El análisis SEM – EDS de material interno (también conocido como EDX o EDAX) se puede realizar de acuerdo con los requisitos de los estándares MIL-STD-883, MIL-STD-750, MIL-STD-1580 y ESCC 25500.
Nuestro sistema SEM tiene la capacidad de proyectar un haz de electrones mínimo de 20 kV sobre la superficie del material que se está analizando con objeto de detectar la presencia de materiales prohibidos. El sistema EDS puede identificar cuantitativamente el porcentaje de peso de cada elemento de material que se está analizando y tiene la capacidad de generar un espectro EDS y datos cuantitativos en un formato de informe completo.
Las muestras de ensayo se deben preparar de tal forma que se optimicen los resultados de los análisis. Los revestimientos para proporcionar una puesta a tierra se deben elegir cuidadosamente. Por otra parte, los materiales usados en los revestimientos elegidos no deben interferir con la consecución del mejor análisis de materiales de la muestra. Siempre que sea posible, se recomienda realizar un corte transversal en la muestra con un área plana de análisis.
Una primera inspección de superficie con la técnica SEM – EDS tendrá como objetivo caracterizar microscópicamente la muestra a fin de obtener un buen conocimiento de su morfología y estructura microcristalina. Además, el sistema SEM – EDS puede contribuir a discriminar casos en los que los límites de la resolución cuantitativa del sistema XRF puedan arrojar resultados no concluyentes en este ensayo.
Microscopios electrónicos de barrido
HELIOS NANOLAB 650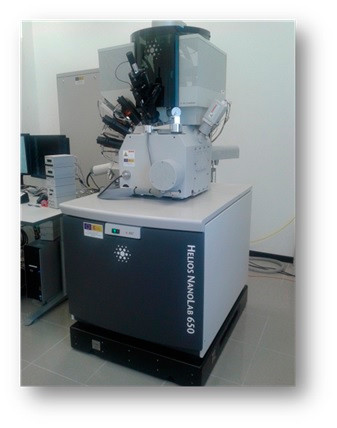
- Microscopio dual de primera categoría de FEI. La columna SEM (columna FESEM con lente de inmersión Elstar XHR) tiene una resolución de 0,8 nm a 15 kV y 0,9 nm a 1 kV.
- Está diseñada para alcanzar una nueva gama de caracterizaciones 2D y 3D con una resolución extremadamente alta (XHR), nanoprototipos y una mayor calidad de la preparación de muestras.
- Detección no destructiva de características internas micrométricas en sistemas microelectrónicos de EEE. - 3rd enero 2022
- Inspección acústica de sistemas híbridos en sustratos laminados - 3rd enero 2022
- Entrada de agua a través de piezas delaminadas en sistemas encapsulados de plástico - 3rd enero 2022